ТОНКОПЛЕНОЧНЫЕ. СОЛНЕЧНЫЕ ЭЛЕМЕНТЫ. НА ОСНОВЕ КРЕМНИЯ
Влияние термообработки на свойства наноструктурированных слоистых пленок a-Si:H
Для определения влияния температурной обработки на свойства слоистых пленок a-Si:H, содержащих нанокристаллические включения, проводился отжиг пленок с оптимальным L = 16 нм в вакууме в течении одного часа при температурах 350, 450, 550 °С. Модификация структуры слоистых пленок a-Si:H на кремниевой подложке исследовалась с помощью электронной микроскопии [87]-[89]. После отжига в вакууме при 450 °С в течение одного часа слоистая структура пленок a-Si:H, полученных в циклическом режиме, заметно размывается (рис. 6.25, а), а отжиг при температуре 550 °С в течение часа делает пленку практически однородной по сечению (рис. 6.25, б). Для пленок a-Si:H, отожженных при температуре 450 и 550 °С наблюдалось некоторое увеличение размера и числа нанокристаллических включений (рис. 6.26). Так после отжига при 450 °С средняя площадь увеличилась с 20 до 60 нм2, а после отжига при 550 °С — до 75 нм2. Это соответствует возрастанию среднего диаметра кристаллитов с
4- 5 до ~ 8-9 нм, соответственно. Процесс кристаллизации в пленках весьма затруднен, о чем свидетельствует малое изменение объемной доли нанокри
сталлической фазы после температурной обработки. Доля занимаемая нанокристаллической фазы увеличилась с 1 % для неотожженной пленки до 4 % после отжига при 450 °С и до 7 % при 550 °С (см. рис. 6.25). При оценке объемной доли кристаллической фазы в пленке после отжига при 550 °С, считая, что нанокристаллиты имеют форму сферы, получаем величину равную примерно 2 %. Столь малая объемная доля нанокристалличекой фазы также не была обнаружена методом рамановской спектроскопии (см. рис. 6.9, б).
 ,L -
,L -
30 нм
а
Рис. 6.25. Фотография ПЭМ в светлопольном контрасте
сечения пленки a-Si:H осажденной с использованием
промежуточного отжига в водородной плазме после отжига
в вакууме при 450 °C (а) и 550 °C (б) в течение одного часа
Следует отметить, что при практически двукратном увеличении объемной доли нанокристаллов после отжига пленок при 450 и 550 °С, характер их распределения по площади сечения, показанный на гистограммах (см. рис. 6.26), меняется незначительно и не происходит существенного сдвига плотности распределения в сторону больших размеров. Это говорит о том, что после отжига при 550 °С объемная доля нанокристаллов возрастает не за счет роста размеров нанокристаллов, а за счет увеличения их числа.
На основании полученных результатов было выдвинуто предположение, что в слоистых пленках при отжиге в вакууме образование кристаллитов происходит в слоях однородного аморфного гидрогенизированного кремния, и рост нанокристаллитов сдерживается интерфейсами с повышенным содержанием водорода. Это подтверждается исследованиями структурных модификаций после отжига в вакууме тонких свободных пленок a-Si:H, осажденных на подложки из NaCl.
Исследования проводились на двух видах пленок:
1) пленки, полученные в непрерывном режиме в течение 6 мин толщиной ~ 40 нм (без отжига слоев в водородосодержащей плазме);
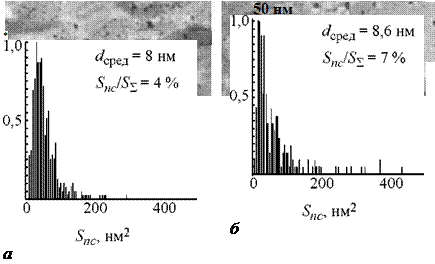 |
Рис. 6.26. Фотографии ПЭМ в темнопольном контрасте поверхности
пленок a-Si:H осажденных с использованием промежуточного отжига
в водородной плазме после отжига в вакууме при T = 450 °C (а)
и 550 °C (б) и соответствующие им гистограммы распределения
нанокристаллитов по площади сечения
2) слоистые пленки, полученные методом циклического осаждения с промежуточной откачкой при смене газовой смеси. Отжиг каждого из трех слоев толщиной 12 нм в водородосодержащей плазме проводился в течении 3 мин при удельной мощности ВЧ-разряда — 200 мВт/см2 и давлении газовой смеси (80 %Ar + 20 %H2) — 25 Па. В исходном состоянии нанокристаллических включений в пленках не наблюдалось.
Результаты электронномикроскопического исследования образцов, термически отожженных при 450 °С в течение 30 мин, приведены на рис. 6.27. После отжига при 450 °С в обеих пленках наблюдается формирование нанокристаллических включений, размером 10-12 нм, занимающих площадь 1-2 %. Появление нанокристаллической фазы в пленках a-Si:H отражается на микродифрактограммах (рис. 6.27). Это позволяет судить об объемной доле кристаллической структуры, которая составляет единицы процентов.
 |
Дальнейшее повышение температуры отжига в вакууме показало, что после термообработки при температуре 750 °С пленки кремния, полученные в режимах 1 и 2, характеризуются совершенно различной структурой (рис. 6.28). Пленка, полученная непрерывным плазмохимическим осаждени-
ем, имеет поликристаллическую структуру и состоит из достаточно крупных (1 мкм и более) кристаллитов (см. рис. 6.28, а). На микродифрактограмме видны рефлексы от отдельных кристаллитов. В то же время пленка, полученная с применением промежуточного отжига в водородной плазме, содержит кристаллиты, типичные размеры которых составляют 10-12 нм (рис. 6.28, б), а отсутствие диффузных колец на микродифрактограмме свидетельствует о преобладающей доле нанокристаллической фазы. Из анализа электронных дифрактограмм следует, что в поликристаллических пленках кремния превалируют кристаллиты с ориентацией [111] по нормали к поверхности.
Таким образом, в слоистых пленках средний размер кристаллитов не превышает толщину слоя, осаждаемого за цикл. Это позволяет управлять размером и долей нанокристаллических включений кремния, что может быть использовано при создании люминесцентных пленок.
|
Рис. 6.29. Зависимости Oph и Oph/Od от температуры отжига для пленки a-Si:H, полученной циклическим методом с L = 16 нм Зависимости темновой и фотопроводимости слоистых пленок от температуры отжига представлены на рис. 6.29. При температурах отжига выше 350 °С наблюдается резкое увеличение темновой проводимости, снижение фотопроводимости и, как результат, уменьшение фоточувствительности пленок a-Si:H до 8-104 (см. рис. 6.29). После отжига при температуре 450 °С фоточувствительность снижается до 102, а после отжига при 550 °С фоточувствительность практически полностью утрачивается. Очевидно, что столь малая объемная доля нанокристаллической фазы не может приводить к увеличению проводимости исходя из представлений теории протекания, а рост темновой проводимости Od, по-видимому, связан с увели- |
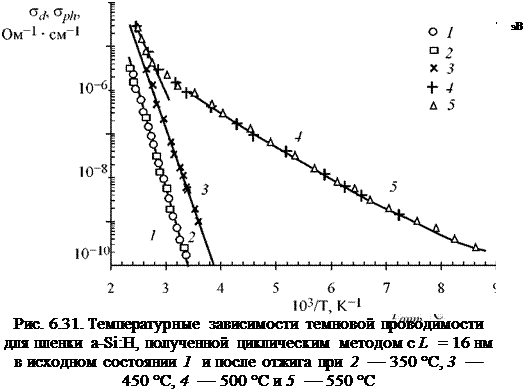 |
чением плотности состояний в пленке a-Si:H. По мере повышения температуры термообработки происходит эффузия водорода, приводящая к повышению плотности локализованных состояний. Как видно из рис. 6.30, концентрация водорода Ch в пленке a-Si:H уменьшается с 17 % в исходной пленке до 10 % — после отжига при 350 оС, 6 % — при 450 оС, а при температурах термообработки выше 500 оС становится менее 2 % [77].
Процесс эффузии водорода сопровождается уменьшением энергии активации Ea с 0,9 до 0,71 эВ после отжига при 450 °С, что связано с уменьшением ширины зоны. При температурах отжига выше 500 °С происходит изменение характера температурной зависимости темновой проводимости. На рис. 6.31 имеются два участка [80]: в области температур больше 380 К — экспоненциальный участок с энергией активации 0,51 эВ соответствует зонной проводимости — при температурах меньше 380 К — проявляется прыжковая проводимость по оборванным связям вблизи уровня Ферми и температурная зависимость описывается выражением для прыжковой проводимости:
®d(T) = A exp [-(T0/T)m] , где A = 80 Ом-1-см-1, T0= 2,8-106 К, m = 0,325.
Зависимость темновой проводимости аналогична для пленок аморфного кремния c малым содержанием водорода (2-3 %) и свидетельствует о высокой степени дефектности материала, вызванной эффузией водорода из пленки.
|
Рис. 6.32. Кинетика изменения фотопроводимости, приведенной к начальной величине, для пленки a-Si:H, полученной циклическим методом с L = 16 нм в исходном состоянии и после отжига при температурах 350 и 450 °С Отжиг в вакууме пленки, полученной циклическим методом с оптимальным L = 16 нм, позволяет еще больше повысить ее стабильность. На рис. 6.32, где представлены результаты по фотоиндуцированной деградации для этой же пленки до отжига и после отжига в вакууме при температурах 350 и 450 °С в течении одного часа. Из полученных данных практический интерес представляет отжиг при 350 °С, после которого стабиль- |
ность пленок значительно возрастает при сохранении отношения Oph/od равного 8-104. Пленки осажденные в циклическом режиме непосредственно при температуре 350 °С обладают очень малой фоточувстительностью CTph/CTd = 6 и энергией активации 0,48 эВ.
На основании исследования пленок a-Si:H, полученных методом циклического осаждения, можно сделать следующие выводы:
1. Впервые с помощью метода циклического осаждения были получены слоистые пленки аморфного гидрогенизированного кремния, содержащие нанокристаллические включения на границах слоев, обладающие повышенной фоточувствительностью (соотношение op^/^d достигает 107 при освещенности 100 мВт/см2) и стабильностью (изменение фотопроводимости в 2,5 раза меньше после воздействия дозы облучения 120 Дж/см2 по сравнению с однородными пленками).
2. Повышение фоточувствительности слоистых пленок a-Si:H обусловлено снижением темновой проводимости, что связано с увеличением концентрации водорода.
3. Показано, что образование нанокристаллических включений в пленках a-Si:H происходит непосредственно в процессе отжига в плазме за счет осаждения кремния из разбавленного водородом остаточного моносилана.
4. Обнаружено, что пленки, получаемые циклическим методом осаждения, характеризуются неоднородным распределением водорода по толщине, что приводит к возникновению дублетов в спектрах фотопроводимости. Неоднородность распределения водорода сохраняется после отжига при температуре не более 450 °С в вакууме, что подтверждается теоретическим расчетом перераспределения концентрации водорода, находящегося в сильных связях с кремнием.
5. Выявлено, что средний размер нанокристаллических включений в слоистых пленках после отжига в вакууме вплоть до температуры 750 °С не превышает толщину слоев пленок a-Si:H, осаждаемых за один цикл, что позволяет управлять размером и содержанием нанокристаллических включений в пленках a-Si:H.
6. На основе слоистых пленок аморфного гидрогенизированного кремния, содержащих нанокристаллические включения, созданы фото приемные структуры с барьером Шоттки, обладающие высокой спектральной чувствительностью (не менее 0,04 А/Вт) в диапазоне 200-400 нм и максимальной чувствительностью 0,2 А/Вт на длине волны 480 нм [90], [91].